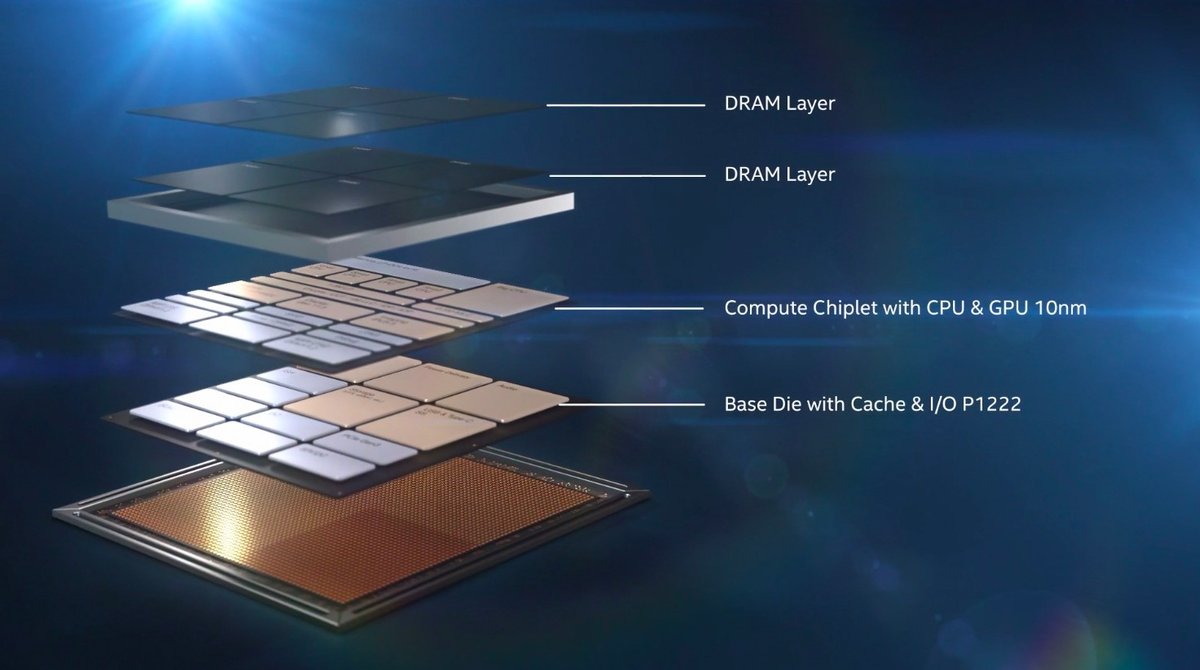
Le CEA annonce qu'il collaborera avec l'Américain Intel pour aider la recherche en matière de puces à technologies d'empilage 3D. Un domaine dans lequel Intel investit beaucoup depuis quelques années. Cette collaboration devrait profiter aux deux entités.
C'est un partenariat que l'on n'avait pas nécessairement vu venir. Le Commissariat à l’énergie atomique et aux énergies alternatives (alias CEA) a annoncé en fin de semaine dernière, par l'intermédiaire d'un communiqué, qu'il collaborerait dorénavant avec Intel pour « faire progresser la conception de puces grâce aux technologies de packaging 3D ». Cette collaboration devrait porter sur plusieurs points, dont les technologies d'interconnexion entre les différents modules des processeurs utilisant cette technique.
L'empilement 3D, Intel connaît
L'empilement 3D est pour rappel l'un des principaux domaines de recherches d'Intel ces dernières années. Le groupe utilise d'ailleurs d'ores et déjà cette technologie sur certaines de ses puces, dont les processeurs Intel Core « Lakefield », que nous avons déjà eu l'occasion de présenter sur Clubic. Le principe est finalement simple : intégrer à la verticale plusieurs éléments hétéroclites et les relier à l'aide d'interconnexions avancées.
C'est justement en grande partie autour de ces interconnexions que le CEA et Intel vont collaborer. L'objectif de cette collaboration est notamment la mise au point de puces hautes performances à empilement 3D (HPC). Ce type de puces pourrait alors par exemple être utilisé pour des serveurs ou sur des supercalculateurs. Actuellement, l'offre d'Intel en la matière se limite surtout à des processeurs à basse, voire très basse consommation pour appareils mobiles.
Les compétences du CEA pourraient servir Intel (et vice-versa)
Si Intel a déjà plus que mis la main à la pâte dans le secteur de l'empilement 3D, le CEA-Leti n'est pas en reste. L'organisme a ainsi reçu en juin dernier le prix du meilleur article lors de la conférence de l'IEEE ECTC pour ses travaux sur l'interposeur actif en silicium, lit-on du communiqué.
Ce dernier permet justement d'améliorer le niveau de communication entre les différents modules d'une puce à empilage 3D. Cette solution, explique le CEA, pourrait ouvrir la voie à de futurs systèmes à haut rendement… avec le domaine HPC en ligne de mire.
Source : communiqué CEA

















